ίΙΗίΖΚί╣▓ό╢Κί╝Πwaferόβ╢ίεΥό╕υίΟγίΕΑSF-3
έΩΟίΞ│όβΓόςλό╕υWAFERίθ║όζ┐όΨ╝ύιΦύμρϋμ╜ύρΜϊ╕φύγΕϋΗείΟγ(ίΟγί║ούψΕίεΞ6Ύ╜η1300╬╝mέΑ╗ύθ╜όΠδύχΩ)
έΩΟώταώΑθ╬╝SecύφΚύ┤γώΘΠό╕υίΞ│όβΓόςλό╕υΎ╝ΝόΟκύΦρίΙΗίΖΚί╣▓ό╢Κό│ΧίψούΠ╛ώταύ▓╛ί║οόςλό╕υίΗΞύΠ╛όΑπΎ╝Ι0.01%ϊ╗ξϊ╕ΜΎ╝Κ
έΩΟWAFERίθ║όζ┐όΨ╝ύιΦύμρϋμ╜ύρΜϊ╕φύγΕϋΗείΟγ
έΩΟώβνϊ║Ηόβ╢ίεΥϊ╣θίΠψώΘΠό╕υίΡΕύρχόρ╣ώΖψϋΗεύφΚ
έΩΟύΟ╗ύΤΔίθ║όζ┐όΨ╝ό╕δϋΨΕϋμ╜ύρΜϊ╕φύγΕίΟγί║οϋχΛίΝΨ(ί╝╖ώΖ╕ύΤ░ίλΔϊ╕φ)
έΩΟLoad Portί╡ΝίΖξί╝Πί░ΙύΦρόςλίΘ║ίβρ
έΩΟϋΔ╜ίδιόΘΚϊ╕ΞίΡΝύΦλόξφίΤΝίΡΕύρχόΔΖό│ΒϋΗείΟγίΙΗίΖΚίβρ(ίΟγί║ούψΕίεΞ10Ύ╜η2600╬╝mέΑ╗SiO2όΠδύχΩ)
ώΘΠό╕υώιΖύδχ
- ίθ║όζ┐όβ╢ίεΥίΟγί║ο
ύΦλίΥΒϋ│ΘϋρΛ
όβ╢ίεΥό╕υίΟγίΕΑSF-3ύΦλίΥΒύΚ╣ϋΚ▓ |
έΩοώτΦύσΞί░ΠήΑΒύεΒύσ║ώΨΥήΑΒϋρφίΓβίχΚϋμζύ░κόαΥΎ╝Ι123 × 128 × 224mmΎ╝Κ
έΩοόΟκύΦρίΙΗίΖΚί╣▓ό╢Κό│ΧίψούΠ╛ώταύ▓╛ί║οόςλό╕υίΗΞύΠ╛όΑπΎ╝Ι0.01%ϊ╗ξϊ╕ΜΎ╝Κ
έΩοϋΔ╜ϊ╗ξώταώΑθώΘΠό╕υΎ╝ΙόεΑί┐τ5kHzΎ╝Κϊ╕ούδμόΟπίΞ│όβΓύιΦύμρίΟγί║ο
έΩοϋΔ╜ίψούΠ╛ώΧ╖ϋ╖ζώδλWorking distanceΎ╝Ιϊ╗ξ50mmΎ╝ΚώΘΠό╕υήΑΒί┤ΒίΖξύΦλύ╖γόδ┤ίΛιύ░κίΨχ
έΩοϊ╜┐ύΦρTCP/IPώΑγϋρΛϊ╛ΗόΟπίΙ╢ϊ╗ξLANϊ╛ΗϋΙΘHostώΑμύ╖γ
έΩοίΠψί░ΞόΘΚίνγί▒νίΟγί║οώΘΠό╕υ
έΩοίερύθφόγτϋ▓╝ίΡΙύγΕόΔΖό│Βϊ╕Μϊ╣θϋΔ╜ώΘΠό╕υίΡΕί▒νίΟγί║ο
ίΙΗίΖΚί╣▓ό╢Κί╝Πwaferόβ╢ίεΥό╕υίΟγίΕΑSF-3ϊ╜┐ύΦρύΚ╣όχΛό│λόχ╡ίζκώΧ╖ϋχΑίΠΨύθ╜όβ╢ίεΥήΑΒύΟ╗ύΤΔύφΚίθ║όζΡίΟγί║οήΑΓώΘΠό╕υί┐τώΑθίΠψύδ┤όΟξόη╢ϋρφόΨ╝ύιΦύμρόσθίΖπΎ╝ΝίψοόβΓύδμόΟπύιΦύμρίΟγί║ού╡ΡόηεήΑΓώΘζί░ΞίΞΛί░ΟώτΦί║ΧόζΡόζΡόΨβύγΕίνγόρμίΝΨ&3D ICίιΗύΨΛίΟγί║οό╕δϋΨΕύγΕώεΑό▒Γϊ╛ΗώΨΜύβ╝ύγΕώΘΠό╕υόΨ╣ό│ΧΎ╝Νί░ΞόΨ╝ύδχίΚΞί╕Γώζλϊ╕ΛίΖ╢ϊ╗ΨύΦρϊ╛ΗώΘΠό╕υίΟγί║ούγΕόΨ╣ί╝Π, ϊ╛ΜίοΓ, ό╕οώδ╗ό╡Β, ώδ╖ί░ΕϋχΛϊ╜ΞϋρΙ(όχ╡ί╖χϋρΙ)ϊ╗ξίνΨόΠΡϊ╛δίΠοίνΨϊ╕ΑύρχώΘΠό╕υόΨ╣ί╝Π, ϋΑΝίερύ▓╛ί║οϊ╗ξίΠΛύσσίχγόΑπϊ╕Λόδ┤ίΜζϊ╕Αύ▒Ν, ϊ╕οϋΔ╜όΦψόΠ┤real timeίΠΛόβΓύιΦύμρώΘΠό╕υήΑΓ
όβ╢ίεΥό╕υίΟγίΕΑSF-3ώΘΠό╕υώιΖύδχ |
ήΑΑίδιόΘΚϊ╕ΞίΡΝώΘΠό╕υί░Ξϋ▒κΎ╝Νϊ╗ξύθ╜όβ╢ίεΥίΟγί║ούΓ║ϊ╛ΜίΠψώΘΠό╕υ6~1300μmήΑΓ
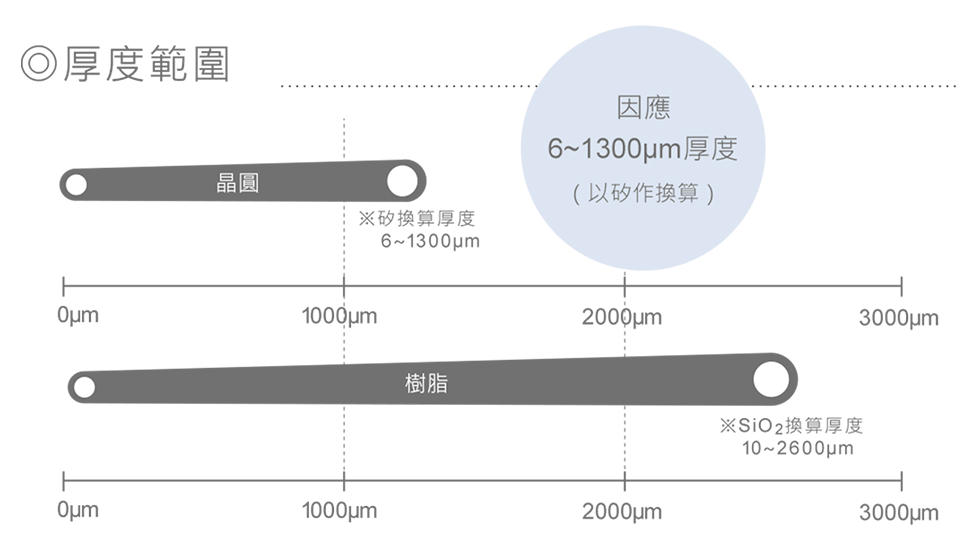
ώταώΑθίΟγί║οώΘΠό╕υ |
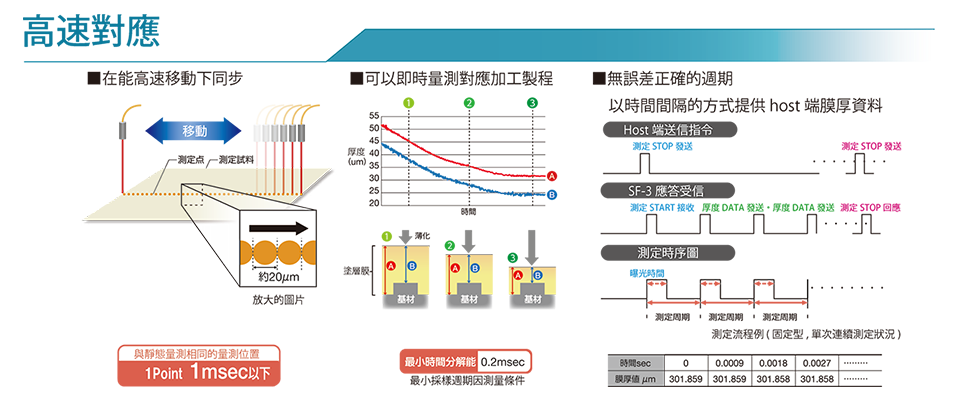
ί╛χί░Πώ╗ηϊ╜ΞώΘΠό╕υ |
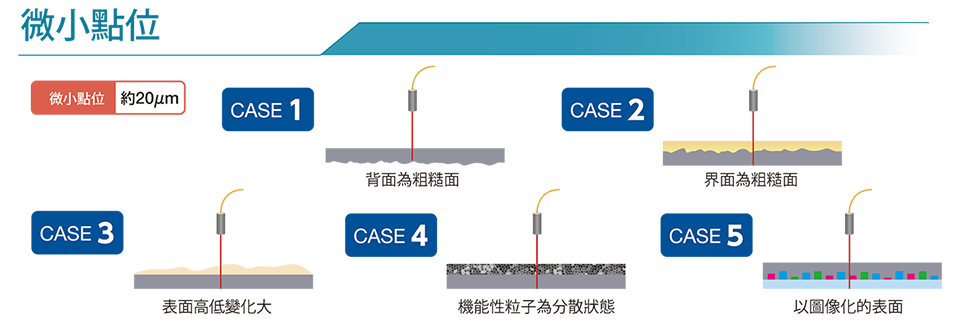
in-situ, ex-situώΘΠό╕υ ύεθύσ║/ύσ┐ώΑΠό╢▓ώτΦ |

ϋμζύ╜χόπΜόΙΡ |
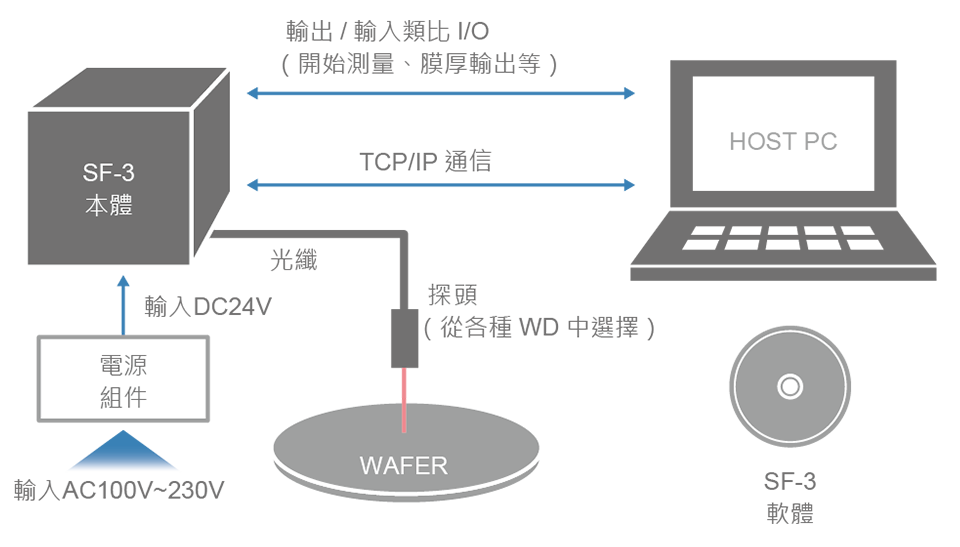
ίΞΛί░ΟώτΦϋμ╜ύρΜϋμζώΖΞϊ╛Μ |
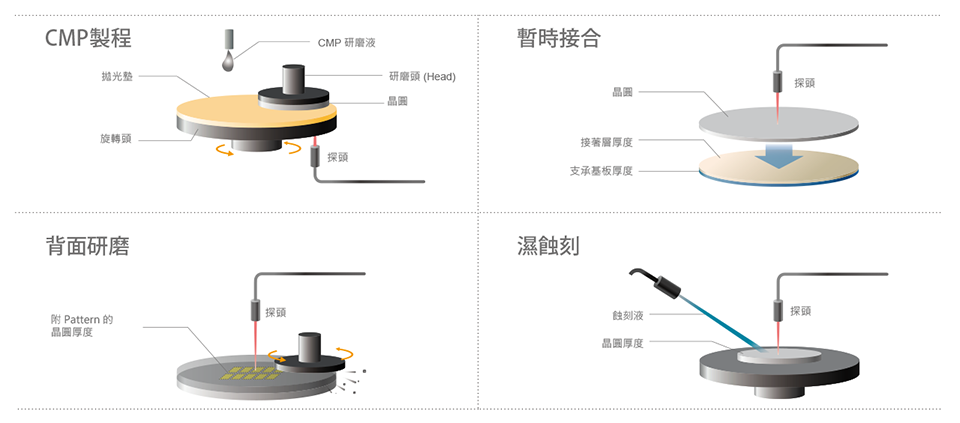
ίΡΕώκηϊ╕ΞίΡΝίΞΛί░ΟώτΦόβ╢ίεΥίθ║όζ┐ίΟγί║οώΘΠό╕υύψΕϊ╛Μ |
-
Si WaferίΟγί║οώΘΠό╕υ

-
SiCίΟγί║οώΘΠό╕υ

-
GaAsίΟγί║οώΘΠό╕υ

-
ALNίΟγί║οώΘΠό╕υ

-
ϋΩΞίψ╢ύθ│ίθ║όζ┐ίΟγί║οώΘΠό╕υ

| ϋΔ╜ίδιόΘΚϊ╕ΞίΡΝύΦλόξφ |

ϋοΠόι╝όρμί╝Π
| ίηΜί╝Π | SF-3/200 | SF-3/300 | SF-3/800 | SF-3/1300 |
|---|---|---|---|---|
| ί░║ίψ╕ | 123*128*224mm | |||
| ύθ╜όβ╢ίεΥώΘΠό╕υύψΕίεΞ | 6-400um | 10-775um | 20-1000um | 50-1300um |
| όρ╣ϋΕΓίΟγί║οώΘΠό╕υύψΕίεΞ | 10-1000um | 20-1500um | 40-2000um | 100-2600um |
| όεΑί░ΠίΠΨόρμώΑ▒όεθ | 5kHz(200us) | |||
| ώΘΠό╕υίΗΞύΠ╛όΑπ | 0.01%ϊ╗ξϊ╕Μ | |||
| ώΘΠό╕υίΖΚόΨΣ | ύδ┤ί╛Σ20umϊ╗ξϊ╕Λ | |||
| ό╕υίχγϋ╖ζώδλ | 50, 80, 120, 150, 200mm | |||
| ίΖΚό║Ρ | ίΞΛί░ΟώτΦίΖΚό║Ρ(ώδ╖ί░Εclass 3Bϋμ╜ίΥΒ) | |||
| ϋπμόηΡόΨ╣ό│Χ | FFTϋπμόηΡ | |||
ώΘΠό╕υύψΕϊ╛Μ
ίΡΕύρχWaferΎ╝ΙSiliconήΑΒίΖ╢ϊ╗ΨίΝΨίΡΙύΚσwaferΎ╝ΚύγΕin-situϋΗείΟγώΘΠό╕υ |
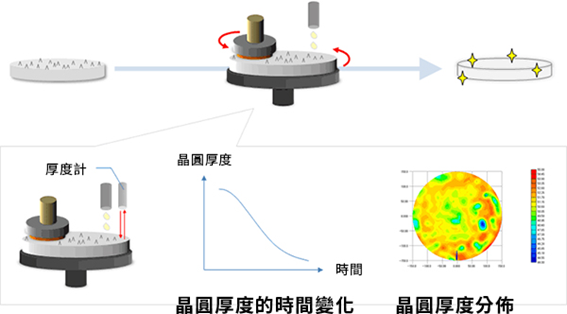 ήΑΑ
ήΑΑ
ίΙΗίΖΚί╣▓ό╢Κί╝ΠWaferϋΗείΟγϋρΙίΠψύδ┤όΟξόη╢ϋρφόΨ╝ύιΦύμρόσθίΖπώΔρΎ╝ΝίερύιΦύμρόβΓίΞ│όβΓώΘΠό╕υύχκύΡΗόβ╢ίεΥίΟγί║οήΑΓήΑΑ
ύιΦύμρί╛Νϋ▓╝ίΡΙwaferίΟγί║οώΘΠό╕υ |

ό╕δϋΨΕί╛Νύθ╜όβ╢ίεΥύγΕίΟγί║οϋΙΘώ╗ΠόΟξόζΡί╛Νί║οώΘΠό╕υύ╡ΡόηεήΑΓώ╗ΠόΟξί▒νύγΕϊ╕ΞίζΘόεΔί╜▒ώθ┐ίΙ░ύθ╜όβ╢ίεΥύιΦύμρύγΕόΙΡόηεήΑΓ
ήΑΑ
ίΙΘίΚΛήΑΒύιΦύμρϊ╕φίΞ│όβΓύδμόΟπόβ╢ίεΥίΟγί║ο |

CMPϋμ╜ύρΜόΨ╝ώΖΞύ╖γί╜λόΙΡί╛ΝΎ╝ΝώΑ▓ϋκΝόβ╢ίεΥϋκρώζλί╣│ίζοίΝΨήΑΓSF-3όΠΡϊ╛δί┤ΒίΖξί╝ΠCMPϋμζύ╜χίΖπύγΕίΞ│όβΓϋΗείΟγώΨΥύσ║ύ│╗ύ╡▒ήΑΓ
ήΑΑ
ϋΘςίΜΧό╕υύ╣ςύ│╗ύ╡▒
| ϋΘςίΜΧό╕υύ╣ςύ│╗ύ╡▒ X-Yϋ╝ΚύΚσίΠ░ |
ήΑΑέΩΠ ύ┤░ί╛χPattern ίχγϊ╜ΞΎ╝ΝόΠΡϊ╛δόβ╢ίεΥίΟγί║οίΤΝίΡΕύρχίΟγί║οϋρΛόΒψ
ήΑΑέΩΠ όΟκύΦρώταύ▓╛ί║οX-Y stageί╖ξϊ╜είΠ░Ύ╝Ι2μmϊ╗ξϊ╕ΜΎ╝Κ Ύ╝Ν ίψούΠ╛ώταύ▓╛ί║οίχγϊ╜Ξ
ήΑΑέΩΠ ίΠψόΦψόΠ┤όβ╢ίεΥϊ╗ξίνΨύγΕί╜λύΜΑ
ήΑΑέΩΠ ίΠψύλ║ϋςΞό╕υώΘΠώ╗ηώΑ▒ώΓΛϋοΨώΘΟ
έΨι ϊ╗ξ150mmϋμ╜ίΥΒύΓ║ϊ╛Μ
ήΑΑέΩΠ ϊ╕╗ϋοΒόΘΚύΦρύψΕίεΞΎ╝γMEMSίΤΝόΕθό╕υίβρϋρφίΓβ
ήΑΑ έΩΟ X-Yίχγϊ╜Ξ2μmϊ╗ξϊ╕Μ έΩΟ όΡφϋ╝ΚPattern matchίΛθϋΔ╜
ήΑΑ
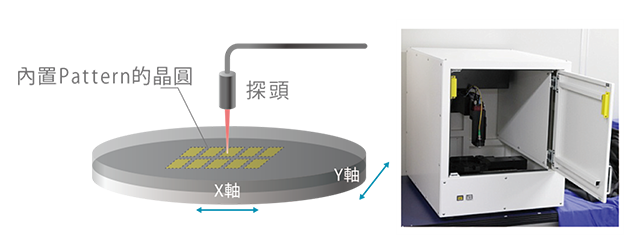
έΨι ϊ╗ξ300mmϋμ╜ίΥΒύΓ║ϊ╛Μ
ήΑΑέΩΠ ϊ╕╗ϋοΒόΘΚύΦρύψΕίεΞΎ╝γίΞΛί░ΟώτΦί░ΙύΦρ300mmόβ╢ίεΥ
ήΑΑ έΩΟ ϋΩΚύΦ▒CCDύλ║ϋςΞό╕υώΘΠώ╗ηϊ╜Ξ έΩΟ όΡφϋ╝ΚPattern matchίΛθϋΔ╜
ήΑΑ

| ϋΘςίΜΧό╕υύ╣ςύ│╗ύ╡▒ R-θϋ╝ΚύΚσίΠ░ |
ήΑΑέΩΠϋΔ╜ώταώΑθόΠΡϊ╛δόβ╢ίεΥώζλίΖπύγΕίΟγί║οϋρΛόΒψ
ήΑΑέΩΠίΠψώΑ▓ϋκΝίνγώ╗ηό╕υύ╣ςό╕υώΘΠ
ήΑΑέΩΠόεΑίνγίΠψό╕υώΘΠΦ300mmόβ╢ίεΥύγΕώζλίΖπίΟγί║ο
ήΑΑέΩΠίΠψίδιόΘΚϋμζώΖΞόβ╢ίεΥύιΦύμρϋμζύ╜χόΙΨόγτόβΓόΟξίΡΙόσθύφΚίΞΛί░ΟώτΦϋμ╜ύρΜϋμζύ╜χ
ήΑΑ ό│ρόΕΠΎ╝ΚίΠψό╕υώΘΠύΚσϊ╗╢Ύ╝γίΔΖώβΡύΕκίΒΠόΝψόζΡόΨβ
έΨι R-θώσΖίΜΧϊ╛Μ
ήΑΑ

όςΦόκΙϊ╕Μϋ╝Κ
-
ίνπίκγύπΣόΛΑύΦλίΥΒίηΜώΝΕ(ύ╢είΡΙ)
ύ╢είΡΙίηΜώΝΕ
όΛΑϋκΥόΨΘύτι
-
25Nov.2025
όβ╢ίεΥώΞ╡ίΡΙϊ╕φύγΕώδ╗ό╝┐όΦ╣ϋ│ςϋκρώζλ Zeta ώδ╗ϊ╜ΞώΘΠό╕υϋΙΘϋμ╜ύρΜόΟπίΙ╢
όβ╢ίεΥώΞ╡ίΡΙόΙΡίΛθύΟΘϋΙΘ SiOέΓΓ ϋκρώζλώδ╗ϋΞ╖ήΑΒύφΚώδλίφΡό┤╗ίΝΨόλζϊ╗╢ώταί║ούδ╕ώΩεήΑΓόευόΨΘϊ╗Μύ┤╣ίοΓϊ╜Χϊ╗ξ ELSZneo ώΑ▓ϋκΝϋκρώζλ Zeta ώδ╗ϊ╜ΞώΘΠό╕υΎ╝ΝίΛσόΓρόΟΝόΠκ OH ίθ║ίψΗί║οϋχΛίΝΨήΑΒόΠΡίΞΘύδ┤όΟξόΟξίΡΙίΥΒϋ│ςΎ╝Νί╝╖ίΝΨίΖΙώΑ▓ί░ΒϋμζϋΙΘ 3D IC ϋμ╜ύρΜύσσίχγόΑπήΑΓ
-
21Sep.2023
ίΖΚί╣▓ό╢ΚίΟθύΡΗόαψϊ╗Αώ║╝Ύ╝θ5ίνπόΘΚύΦρύψΕύΨΘΎ╝Νί░Ιίχ╢ί╕╢ϊ╜ιό╖▒ίΖξϊ║ΗϋπμΎ╝Β
ίΖΚί╣▓ό╢ΚίΟθύΡΗΎ╝ΝίΠψό╢ΚίΠΛίΙ░ίΖΚίφ╕ίΤΝόζΡόΨβύπΣίφ╕ύφΚίνγίΑΜίφ╕ύπΣήΑΓϊ╕ΦίερίΡΕύρχόΛΑϋκΥίΤΝί╖ξόξφώιαίθθϊ╕φΎ╝Νϊ╣θώΔ╜όεΚϋΣΩί╗μό│δύγΕόΘΚύΦρΎ╝Νϊ╛ΜίοΓΎ╝γίΖΚίφ╕ίΕΑίβρύγΕόικό║ΨήΑΒύΦθύΚσώΗτίφ╕όΙΡίΔΠϋΙΘύ▓╛ίψΗύγΕύΚσϋ│ςό╕υώΘΠύφΚήΑΓύΧ╢ίΖσόζθόΙΨίνγόζθίΡΝώι╗ύΟΘύγΕίΖΚό│λίερύδ╕ίΡΝύγΕύσ║ώΨΥϊ╕φώΘΞύΨΛόβΓΎ╝ΝύΦ▒όΨ╝ίχΔίΑΣύγΕύδ╕ϊ╜Ξί╖χύΧ░Ύ╝ΝόεΔύΦλύΦθόαΟόγΩϊ║νόδ┐ύγΕί╣▓ό╢Κόλζύ┤ΜήΑΓϋΑΝώΑβύρχύΠ╛ϋ▒κϊ╕ΞίΔΖόΠφύν║ϊ║ΗίΖΚύγΕό│λίΜΧόΑπΎ╝Νόδ┤ύΓ║ύΠ╛ϊ╗μύπΣόΛΑί╕╢ϊ╛Ηϊ║ΗύΕκόΧ╕ύγΕόικό║ΨϋΙΘόΘΚύΦρύγΕίΠψϋΔ╜όΑπΎ╝Β
-
14Nov.2025
Waferόαψϊ╗Αώ║╝Ύ╝θίΚΞί╛Ν2ίνπίΞΛί░ΟώτΦϋμ╜ύρΜΎ╝Νί╕╢ϊ╜ιόΟΝόΠκόβ╢ίεΥύγΕύξΧίψΗΎ╝Β
ϋρ▒ίνγϊ║║ί░ΞόΨ╝ίΞΛί░ΟώτΦύΦλόξφϊ╕ΞύΗθόΓΚΎ╝Νί░νίΖ╢όαψί░ΞίΞΛί░ΟώτΦϋμ╜ύρΜύγΕόοΓί┐╡όδ┤όαψϊ╕ΑύθξίΞΛϋπμΎ╝θΎ╝ΒίΖ╢ίψοΎ╝Νϊ╕╗ϋοΒόαψύΦρϊ╛Ηϋμ╜ϊ╜εόβ╢ύΚΘύγΕίΞΛί░ΟώτΦϋμ╜ύρΜΎ╝ΝόαψώεΑϋοΒώΑΠώΒΟϊ╕Αύ│╗ίΙΩύγΕί░ΙόξφόφξώσθϋΙΘόΡφώΖΞύ▓Τί╛Σϊ╗ξίΠΛώξΔίΟγώΘΠό╕υί╛ΝΎ╝ΝόΚΞϋΔ╜ϋλτίχΝόΧ┤ύγΕώΒΜύΦρίερίΡΕίΑΜύΦλόξφϊ╣Μϊ╕φήΑΓϋΜξϊ╜ιί░ΞόΨ╝ίΞΛί░ΟώτΦϋμ╜ύρΜώΓΕόαψόεΚϋρ▒ίνγύΨΣίΧΠύγΕϋσ▒Ύ╝Νϊ╕Ξίορί░▒ϊ╕Αϋ╡╖ώΑΠώΒΟόευύψΘί░Ιίχ╢ύγΕϋυδϋπμϊ╛Ηϊ║ΗϋπμίΡπΎ╝Β
-
06Dec.2022
CMPόαψϊ╗Αώ║╝όΕΠόΑζΎ╝θSlurryϋμ╜ύρΜό╖▒ίΖξϊ╗Μύ┤╣Ύ╝Νό╕ΖόξγύηφϋπμόΛΑϋκΥϋΙΘίΟθύΡΗΎ╝Β
CMPόαψϊ╗Αώ║╝όΕΠόΑζΎ╝θϋμ╜ύρΜϊ╕φίΠψόΘΚύΦρίερίΥςϊ║δύΤ░ύψΑΎ╝θ
ϋχΥϊ╜ιί┐τώΑθϊ║ΗϋπμCMPϋμ╜ύρΜύγΕύδ╕ώΩείΖπίχ╣ϋΙΘόΘΚύΦρΎ╝Β -
31Jul.2024
ϋΗείΟγϋρΙύρχώκηόεΚίΥςϊ║δΎ╝θό╕Ζόξγϊ║ΗϋπμόΛΑϋκΥίΟθύΡΗΎ╝ΝίψοώγδόΘΚύΦρύψΕίεΞϊ╕ΑόΛΛόΛΥΎ╝Β
ί╕Γώζλϊ╕ΛϋΗείΟγϋρΙύβ╛ύβ╛όυ╛ϋσ▓όΑΟώ║╝ώΒ╕όΥΘ?ίΥςύρχώΘΠό╕υόΨ╣όψΦϋ╝ΔώΒσίΡΙόΙΣύγΕόρμίΥΒ?
ϋΑΔώΘΠϊ╕ΞίΡΝϋΗεί▒νόζΡϋ│ςύρχώκηήΑΒϋρφύ╜χίι┤όΚΑήΑΒώιΡύχΩύφΚύφΚόεΚϊ╕ΞίΡΝώΒ╕όΥΘήΑΓ -
10Jan.2022
ήΑΡίΖΚίφ╕ϋΗείΟγώΘΠό╕υήΑΣίνγί▒νύ╡ΡόπΜύθ╜όβ╢ίεΥό╕δϋΨΕύιΦύμρϋΗείΟγώΘΠό╕υ
ύΧ╢όβ╢ίεΥώΑ▓ϋκΝύιΦύμρόΙΨϋζΧίΙ╗ό╕δϋΨΕίΟγί║οόβΓΎ╝ΝώΑ▓ϋκΝίΞ│όβΓίΟγί║ούδμόΟπΎ╝δίΠψόΨ╝ύ╖γϊ╕Λύλ║ϋςΞύιΦύμρίΟγί║οΎ╝Νϊ╕ΞώιΙίΒεόσθύλ║ϋςΞΎ╝ΝόΠΡώταϋμ╜όΙΡόΧΙύΟΘήΑΓ