FE-300
膜厚量測儀FE-300
◎薄膜到厚膜的量測範圍、UV~NIR光譜分析
◎高性能的性價比光學薄膜量測儀
◎藉由絕對反射率光譜分析膜厚
◎無複雜設定,操作簡單,短時間內即可上手
◎線性最小平方法解析光學常數(n:折射率、k:消光係數)
◎高性能的性價比光學薄膜量測儀
◎藉由絕對反射率光譜分析膜厚
◎無複雜設定,操作簡單,短時間內即可上手
◎線性最小平方法解析光學常數(n:折射率、k:消光係數)
量測項目
- 多層膜解析
- 光學常數nk值(n:折射率、k:消光係數)
產品資訊
| 特色 |
使用反射光譜作為膜厚解析
一體型・低價格以非接触・非破壊的方式實現高精度量測
簡單的條件設定與測定操作!簡單上手的膜厚測定方式
波峰波谷法、傅立葉轉換FFT解析法、非線形最小二乗法(Fitting)、最適化法等多種類膜厚量測分析
非線形最小二乗法(Fitting)膜厚解析演算、光学定数解析(n:曲折率、k:消光係數)代入
| 量測項目 |
膜厚解析(10層)
光学參數解析(n:曲折率、k:消光係數)
| 量測對象 |
透明導電膜(ITO、銀Nanowire)、位相差Film材、偏光Film材、AR Film材、PET、PEN、TAC、PP、PC、PE、PVA、接着剤、粘着剤、保護Film材、HardCoat、耐指紋剤等
半導体
化合物半導体、Si、氧化膜、氮化膜、Resist、SiC、GaAs、GaN、InP、InGaAs、 SOI、Sapphire等
表面處理
DLC coat、防鏽劑、防霧劑等
光学材料
Filter、AR coat等
FPD
LCD(CF、ITO、LC、PI)、OLED(有機膜、封止劑)等
其他
HDD、磁気Tape、建材等
量測原理
反射分光法
光干涉法搭配高速、高精度的自家光譜儀技術,提供非接觸、不破壞樣品的膜厚量測方案。在(圖2)的光學系統中,光譜儀解析量測光源照射在樣品後所得到的反射率,同時進行光學膜厚演算。在(圖1)中,以金屬基板上的膜層為量測對象,光源照射在膜層表面後被反射為 (R1)。光源透過膜層入射在金屬基板與膜層介面間的反射為 (R2)。R1與R2間因光程一長一短的延遲現象而産生相位差,而藉由解析此相位差所得到的反射光譜與屈折率,進而演算膜厚,即稱之為光干涉法。解析手法共有波峰-波谷法 (P-V),快速傅立葉轉換法 (FFT),非線性最小平方法 (Curve Fitting),最適化法 (Optimiztion) 等四種。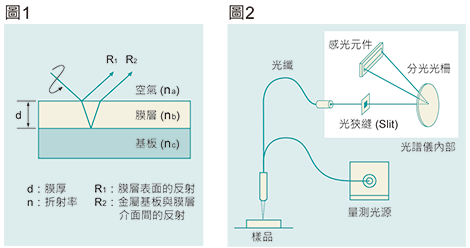
規格樣式
| 型式 | 薄膜型標準型 | |
|---|---|---|
| 測定波長範圍 | 300~800nm | |
| 測定膜厚範圍 (SiO2換算) |
3nm-35um | |
| 量測光斑直徑 | φ1.2mm | |
| 對應樣品尺寸 | φ200×5(H)mm | |
| 測定時間 | 0.1~10s以内 | |
| 電源 | AC100V±10% 300VA | |
| 尺寸&重量 | 280(W)×570(D)×350(H)mm、24kg | |
| 其他 | 標準反射片、Receipe編輯服務 | |
裝置構成
| 晶圓和透明基板能對應2種類光學系 |
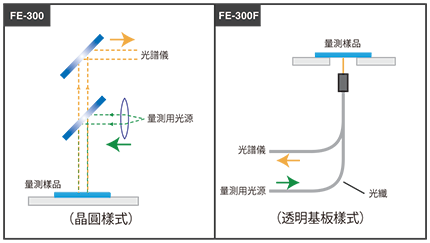
| 對話視窗方式可簡單的量測解析膜厚 |


檔案下載
technical article
技術文章
-
21Sep.2023
光干涉原理是什麼?5大應用範疇,專家帶你深入了解!
光干涉原理,可涉及到光學和材料科學等多個學科。且在各種技術和工業領域中,也都有著廣泛的應用,例如:光學儀器的校準、生物醫學成像與精密的物質測量等。當兩束或多束同頻率的光波在相同的空間中重疊時,由於它們的相位差異,會產生明暗交替的干涉條紋。而這種現象不僅揭示了光的波動性,更為現代科技帶來了無數的校準與應用的可能性!
-
31Jul.2024
膜厚計種類有哪些?清楚了解技術原理,實際應用範圍一把抓!
市面上膜厚計百百款該怎麼選擇?哪種量測方比較適合我的樣品?
考量不同膜層材質種類、設置場所、預算等等有不同選擇。 -
01Mar.2022
【入門】透過分光法對膜厚進行解析
使用分光光度計的量測方式,操作簡單且可不破壞及非接觸式進行量測,只要有屈折率便可執行高精度的量測
Related Products