еҲҶе…үе№Іж¶үејҸwaferжҷ¶ең“жё¬еҺҡе„ҖSF-3
в—ҺеҚіжҷӮжӘўжё¬WAFERеҹәжқҝж–јз ”зЈЁиЈҪзЁӢдёӯзҡ„иҶңеҺҡ(еҺҡеәҰзҜ„еңҚ6пҪһ1300ОјmвҖ»зҹҪжҸӣз®—)
в—Һй«ҳйҖҹОјSecзӯүзҙҡйҮҸжё¬еҚіжҷӮжӘўжё¬пјҢжҺЎз”ЁеҲҶе…үе№Іж¶үжі•еҜҰзҸҫй«ҳзІҫеәҰжӘўжё¬еҶҚзҸҫжҖ§пјҲ0.01%д»ҘдёӢпјү
в—ҺWAFERеҹәжқҝж–јз ”зЈЁиЈҪзЁӢдёӯзҡ„иҶңеҺҡ
в—ҺзҺ»з’ғеҹәжқҝж–јжёӣи–„иЈҪзЁӢдёӯзҡ„еҺҡеәҰи®ҠеҢ–(еј·й…ёз’°еўғдёӯ)
в—ҺLoad PortеөҢе…ҘејҸе°Ҳз”ЁжӘўеҮәеҷЁ
в—ҺиғҪеӣ жҮүдёҚеҗҢз”ўжҘӯе’Ңеҗ„зЁ®жғ…жіҒиҶңеҺҡеҲҶе…үеҷЁ(еҺҡеәҰзҜ„еңҚ10пҪһ2600ОјmвҖ»SiO2жҸӣз®—)
йҮҸжё¬й …зӣ®
- еҹәжқҝжҷ¶ең“еҺҡеәҰ
з”ўе“ҒиіҮиЁҠ
жҷ¶ең“жё¬еҺҡе„ҖSF-3з”ўе“Ғзү№иүІ |
в—Ұй«”з©Қе°ҸгҖҒзңҒз©әй–“гҖҒиЁӯеӮҷе®үиЈқз°Ўжҳ“пјҲ123 × 128 × 224mmпјү
в—ҰжҺЎз”ЁеҲҶе…үе№Іж¶үжі•еҜҰзҸҫй«ҳзІҫеәҰжӘўжё¬еҶҚзҸҫжҖ§пјҲ0.01%д»ҘдёӢпјү
в—ҰиғҪд»Ҙй«ҳйҖҹйҮҸжё¬пјҲжңҖеҝ«5kHzпјүдёҰзӣЈжҺ§еҚіжҷӮз ”зЈЁеҺҡеәҰ
в—ҰиғҪеҜҰзҸҫй•·и·қйӣўWorking distanceпјҲд»Ҙ50mmпјүйҮҸжё¬гҖҒеҙҒе…Ҙз”ўз·ҡжӣҙеҠ з°Ўе–®
в—ҰдҪҝз”ЁTCP/IPйҖҡиЁҠдҫҶжҺ§еҲ¶д»ҘLANдҫҶиҲҮHostйҖЈз·ҡ
в—ҰеҸҜе°ҚжҮүеӨҡеұӨеҺҡеәҰйҮҸжё¬
в—ҰеңЁзҹӯжҡ«иІјеҗҲзҡ„жғ…жіҒдёӢд№ҹиғҪйҮҸжё¬еҗ„еұӨеҺҡеәҰ
еҲҶе…үе№Іж¶үејҸwaferжҷ¶ең“жё¬еҺҡе„ҖSF-3дҪҝз”Ёзү№ж®Ҡжіўж®өеқЎй•·и®ҖеҸ–зҹҪжҷ¶ең“гҖҒзҺ»з’ғзӯүеҹәжқҗеҺҡеәҰгҖӮйҮҸжё¬еҝ«йҖҹеҸҜзӣҙжҺҘжһ¶иЁӯж–јз ”зЈЁж©ҹе…§пјҢеҜҰжҷӮзӣЈжҺ§з ”зЈЁеҺҡеәҰзөҗжһңгҖӮйҮқе°ҚеҚҠе°Һй«”еә•жқҗжқҗж–ҷзҡ„еӨҡжЁЈеҢ–&3D ICе Ҷз–ҠеҺҡеәҰжёӣи–„зҡ„йңҖжұӮдҫҶй–Ӣзҷјзҡ„йҮҸжё¬ж–№жі•пјҢе°Қж–јзӣ®еүҚеёӮйқўдёҠе…¶д»–з”ЁдҫҶйҮҸжё¬еҺҡеәҰзҡ„ж–№ејҸ, дҫӢеҰӮ, жёҰйӣ»жөҒ, йӣ·е°„и®ҠдҪҚиЁҲ(ж®өе·®иЁҲ)д»ҘеӨ–жҸҗдҫӣеҸҰеӨ–дёҖзЁ®йҮҸжё¬ж–№ејҸ, иҖҢеңЁзІҫеәҰд»ҘеҸҠз©©е®ҡжҖ§дёҠжӣҙеӢқдёҖзұҢ, дёҰиғҪж”ҜжҸҙreal timeеҸҠжҷӮз ”зЈЁйҮҸжё¬гҖӮ
жҷ¶ең“жё¬еҺҡе„ҖSF-3йҮҸжё¬й …зӣ® |
гҖҖеӣ жҮүдёҚеҗҢйҮҸжё¬е°ҚиұЎпјҢд»ҘзҹҪжҷ¶ең“еҺҡеәҰзӮәдҫӢеҸҜйҮҸжё¬6~1300μmгҖӮ
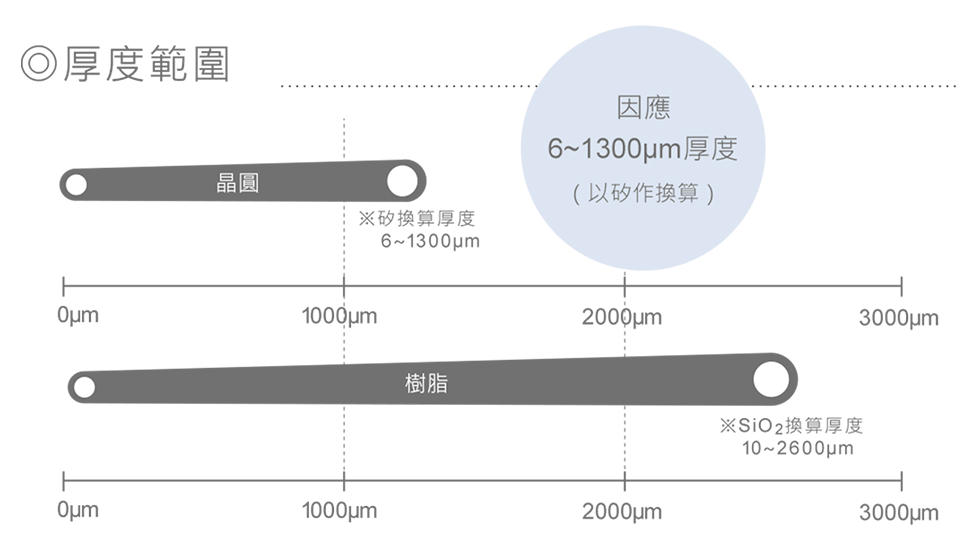
й«ҳйҖҹеҺҡеәҰйҮҸжё¬ |
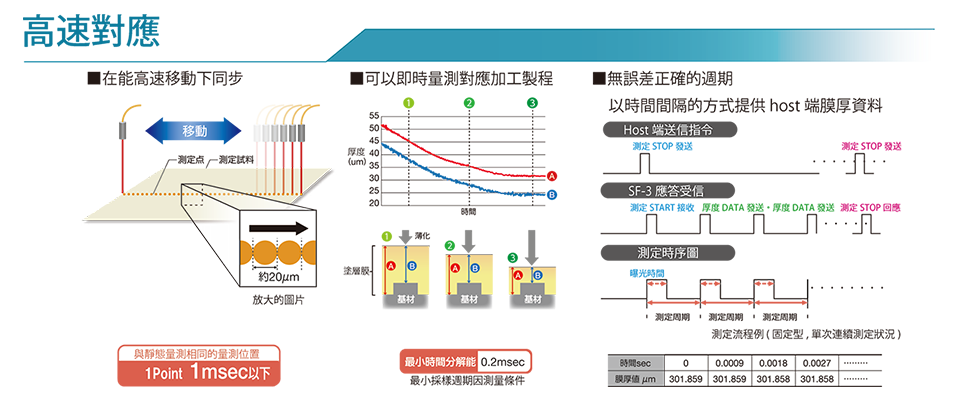
еҫ®е°Ҹй»һдҪҚйҮҸжё¬ |
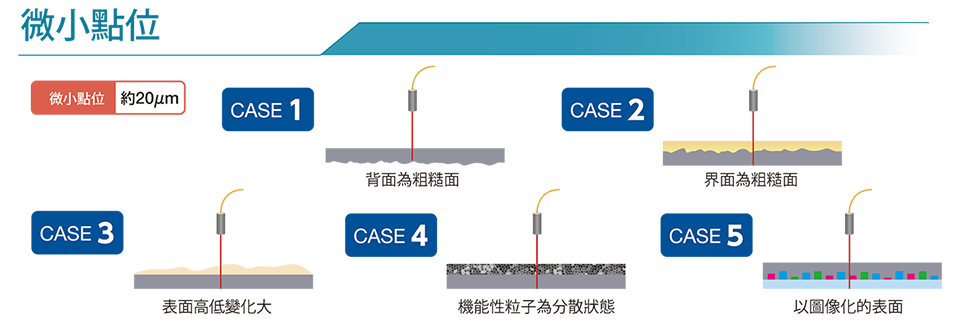
in-situ, ex-situйҮҸжё¬ зңҹз©ә/з©ҝйҖҸж¶Ій«” |

иЈқзҪ®ж§ӢжҲҗ |
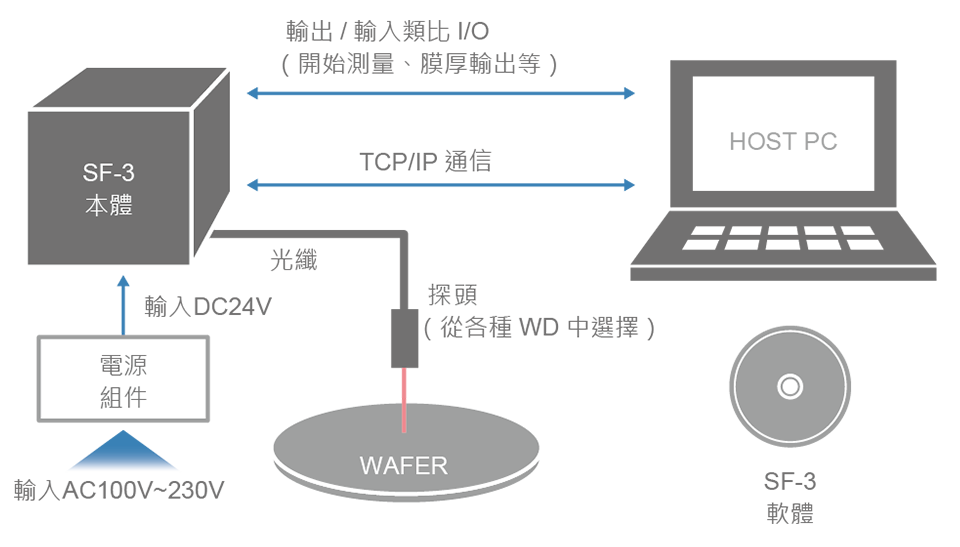
еҚҠе°Һй«”иЈҪзЁӢиЈқй…ҚдҫӢ |
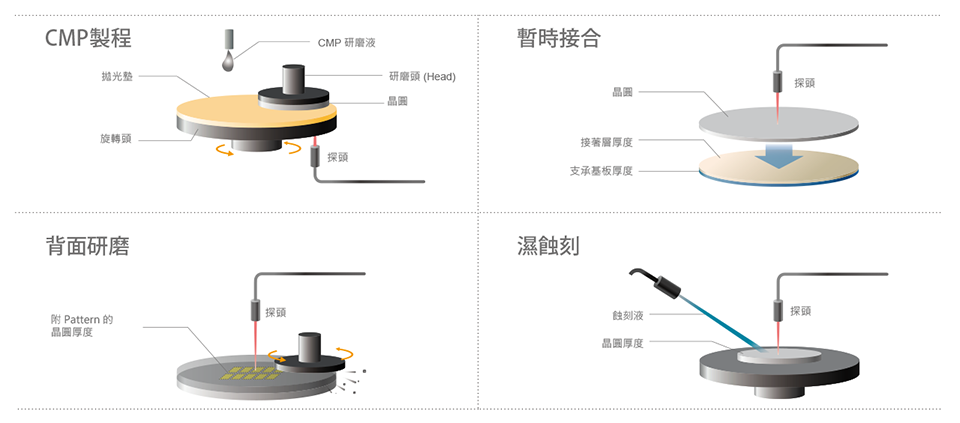
еҗ„йЎһдёҚеҗҢеҚҠе°Һй«”жҷ¶ең“еҹәжқҝеҺҡеәҰйҮҸжё¬зҜ„дҫӢ |
-
Si WaferеҺҡеәҰйҮҸжё¬

-
SiCеҺҡеәҰйҮҸжё¬

-
GaAsеҺҡеәҰйҮҸжё¬

-
ALNеҺҡеәҰйҮҸжё¬

-
и—ҚеҜ¶зҹіеҹәжқҝеҺҡеәҰйҮҸжё¬

| иғҪеӣ жҮүдёҚеҗҢз”ўжҘӯ |

иҰҸж јжЁЈејҸ
| еһӢејҸ | SF-3/200 | SF-3/300 | SF-3/800 | SF-3/1300 |
|---|---|---|---|---|
| е°әеҜё | 123*128*224mm | |||
| зҹҪжҷ¶ең“йҮҸжё¬зҜ„еңҚ | 6-400um | 10-775um | 20-1000um | 50-1300um |
| жЁ№и„ӮеҺҡеәҰйҮҸжё¬зҜ„еңҚ | 10-1000um | 20-1500um | 40-2000um | 100-2600um |
| жңҖе°ҸеҸ–жЁЈйҖұжңҹ | 5kHz(200us) | |||
| йҮҸжё¬еҶҚзҸҫжҖ§ | 0.01%д»ҘдёӢ | |||
| йҮҸжё¬е…үж–‘ | зӣҙеҫ‘20umд»ҘдёҠ | |||
| жё¬е®ҡи·қйӣў | 50, 80, 120, 150, 200mm | |||
| е…үжәҗ | еҚҠе°Һй«”е…үжәҗ(йӣ·е°„class 3BиЈҪе“Ғ) | |||
| и§Јжһҗж–№жі• | FFTи§Јжһҗ | |||
йҮҸжё¬зҜ„дҫӢ
еҗ„зЁ®WaferпјҲSiliconгҖҒе…¶д»–еҢ–еҗҲзү©waferпјүзҡ„in-situиҶңеҺҡйҮҸжё¬ |
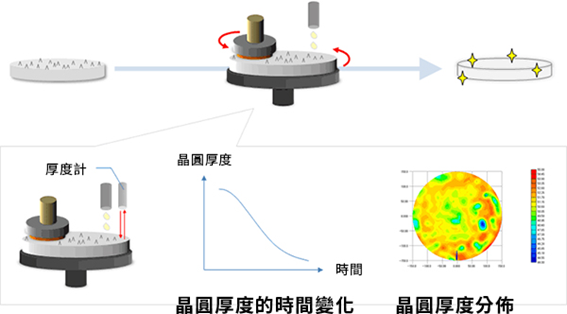 гҖҖ
гҖҖ
еҲҶе…үе№Іж¶үејҸWaferиҶңеҺҡиЁҲеҸҜзӣҙжҺҘжһ¶иЁӯж–јз ”зЈЁж©ҹе…§йғЁпјҢеңЁз ”зЈЁжҷӮеҚіжҷӮйҮҸжё¬з®ЎзҗҶжҷ¶ең“еҺҡеәҰгҖӮгҖҖ
з ”зЈЁеҫҢиІјеҗҲwaferеҺҡеәҰйҮҸжё¬ |

жёӣи–„еҫҢзҹҪжҷ¶ең“зҡ„еҺҡеәҰиҲҮй»ҸжҺҘжқҗеҫҢеәҰйҮҸжё¬зөҗжһңгҖӮй»ҸжҺҘеұӨзҡ„дёҚеқҮжңғеҪұйҹҝеҲ°зҹҪжҷ¶ең“з ”зЈЁзҡ„жҲҗжһңгҖӮ
гҖҖ
еҲҮеүҠгҖҒз ”зЈЁдёӯеҚіжҷӮзӣЈжҺ§жҷ¶ең“еҺҡеәҰ |

CMPиЈҪзЁӢж–јй…Қз·ҡеҪўжҲҗеҫҢпјҢйҖІиЎҢжҷ¶ең“иЎЁйқўе№іеқҰеҢ–гҖӮSF-3жҸҗдҫӣеҙҒе…ҘејҸCMPиЈқзҪ®е…§зҡ„еҚіжҷӮиҶңеҺҡй–“з©әзі»зөұгҖӮ
гҖҖ
иҮӘеӢ•жё¬з№Әзі»зөұ
| иҮӘеӢ•жё¬з№Әзі»зөұ X-Yијүзү©еҸ° |
гҖҖв—Ҹ зҙ°еҫ®Pattern е®ҡдҪҚпјҢжҸҗдҫӣжҷ¶ең“еҺҡеәҰе’Ңеҗ„зЁ®еҺҡеәҰиЁҠжҒҜ
гҖҖв—Ҹ жҺЎз”Ёй«ҳзІҫеәҰX-Y stageе·ҘдҪңеҸ°пјҲ2μmд»ҘдёӢпјү пјҢ еҜҰзҸҫй«ҳзІҫеәҰе®ҡдҪҚ
гҖҖв—Ҹ еҸҜж”ҜжҸҙжҷ¶ең“д»ҘеӨ–зҡ„еҪўзӢҖ
гҖҖв—Ҹ еҸҜзўәиӘҚжё¬йҮҸй»һйҖұйӮҠиҰ–йҮҺ
в– д»Ҙ150mmиЈҪе“ҒзӮәдҫӢ
гҖҖв—Ҹ дё»иҰҒжҮүз”ЁзҜ„еңҚпјҡMEMSе’Ңж„ҹжё¬еҷЁиЁӯеӮҷ
гҖҖ в—Һ X-Yе®ҡдҪҚ2μmд»ҘдёӢ в—Һ жҗӯијүPattern matchеҠҹиғҪ
гҖҖ
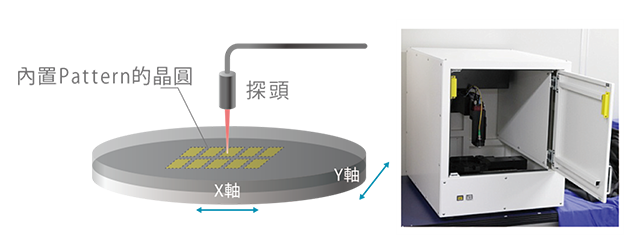
в– д»Ҙ300mmиЈҪе“ҒзӮәдҫӢ
гҖҖв—Ҹ дё»иҰҒжҮүз”ЁзҜ„еңҚпјҡеҚҠе°Һй«”е°Ҳз”Ё300mmжҷ¶ең“
гҖҖ в—Һ и—үз”ұCCDзўәиӘҚжё¬йҮҸй»һдҪҚ в—Һ жҗӯијүPattern matchеҠҹиғҪ
гҖҖ

| иҮӘеӢ•жё¬з№Әзі»зөұ R-θијүзү©еҸ° |
гҖҖв—ҸиғҪй«ҳйҖҹжҸҗдҫӣжҷ¶ең“йқўе…§зҡ„еҺҡеәҰиЁҠжҒҜ
гҖҖв—ҸеҸҜйҖІиЎҢеӨҡй»һжё¬з№Әжё¬йҮҸ
гҖҖв—ҸжңҖеӨҡеҸҜжё¬йҮҸΦ300mmжҷ¶ең“зҡ„йқўе…§еҺҡеәҰ
гҖҖв—ҸеҸҜеӣ жҮүиЈқй…Қжҷ¶ең“з ”зЈЁиЈқзҪ®жҲ–жҡ«жҷӮжҺҘеҗҲж©ҹзӯүеҚҠе°Һй«”иЈҪзЁӢиЈқзҪ®
гҖҖ жіЁж„ҸпјүеҸҜжё¬йҮҸзү©д»¶пјҡеғ…йҷҗз„ЎеҒҸжҢҜжқҗж–ҷ
в– R-θй©…еӢ•дҫӢ
гҖҖ

жҠҖиЎ“ж–Үз«
-
21Sep.2023
е…үе№Іж¶үеҺҹзҗҶжҳҜд»Җйәјпјҹ5еӨ§жҮүз”ЁзҜ„з–ҮпјҢе°Ҳ家帶дҪ ж·ұе…ҘдәҶи§ЈпјҒ
е…үе№Іж¶үеҺҹзҗҶпјҢеҸҜж¶үеҸҠеҲ°е…үеӯёе’Ңжқҗж–ҷ科еӯёзӯүеӨҡеҖӢеӯёз§‘гҖӮдё”еңЁеҗ„зЁ®жҠҖиЎ“е’Ңе·ҘжҘӯй ҳеҹҹдёӯпјҢд№ҹйғҪжңүи‘—е»Јжіӣзҡ„жҮүз”ЁпјҢдҫӢеҰӮпјҡе…үеӯёе„ҖеҷЁзҡ„ж Ўжә–гҖҒз”ҹзү©йҶ«еӯёжҲҗеғҸиҲҮзІҫеҜҶзҡ„зү©иіӘжё¬йҮҸзӯүгҖӮ當兩жқҹжҲ–еӨҡжқҹеҗҢй »зҺҮзҡ„е…үжіўеңЁзӣёеҗҢзҡ„з©әй–“дёӯйҮҚз–ҠжҷӮпјҢз”ұж–је®ғеҖ‘зҡ„зӣёдҪҚе·®з•°пјҢжңғз”ўз”ҹжҳҺжҡ—дәӨжӣҝзҡ„е№Іж¶үжўқзҙӢгҖӮиҖҢйҖҷзЁ®зҸҫиұЎдёҚеғ…жҸӯзӨәдәҶе…үзҡ„жіўеӢ•жҖ§пјҢжӣҙзӮәзҸҫ代科жҠҖеё¶дҫҶдәҶз„Ўж•ёзҡ„ж Ўжә–иҲҮжҮүз”Ёзҡ„еҸҜиғҪжҖ§пјҒ
-
21Jun.2023
еҚҠе°Һй«”иЈҪзЁӢй ҶеәҸеӨ§е…¬й–ӢпјҒе°Ҳ家用11жӯҘй©ҹе‘ҠиЁҙдҪ пјҢе°ҲжҘӯжҠҖиЎ“еӨ§и§ЈеҜҶпјҒ
иЁұеӨҡдәәе°Қж–јеҚҠе°Һй«”з”ўжҘӯдёҚзҶҹжӮүпјҢе°Өе…¶жҳҜе°ҚеҚҠе°Һй«”иЈҪзЁӢзҡ„жҰӮеҝөжӣҙжҳҜдёҖзҹҘеҚҠи§ЈпјҹпјҒе…¶еҜҰпјҢдё»иҰҒжҳҜз”ЁдҫҶиЈҪдҪңжҷ¶зүҮзҡ„еҚҠе°Һй«”иЈҪзЁӢпјҢжҳҜйңҖиҰҒйҖҸйҒҺдёҖзі»еҲ—зҡ„е°ҲжҘӯжӯҘй©ҹиҲҮжҗӯй…ҚзІ’еҫ‘д»ҘеҸҠйҘғеҺҡйҮҸжё¬еҫҢпјҢжүҚиғҪиў«е®Ңж•ҙзҡ„йҒӢз”ЁеңЁеҗ„еҖӢз”ўжҘӯд№ӢдёӯгҖӮиӢҘдҪ е°Қж–јеҚҠе°Һй«”иЈҪзЁӢйӮ„жҳҜжңүиЁұеӨҡз–‘е•Ҹзҡ„и©ұпјҢдёҚеҰЁе°ұдёҖиө·йҖҸйҒҺжң¬зҜҮе°Ҳ家зҡ„и¬ӣи§ЈдҫҶдәҶи§Јеҗ§пјҒ
-
06Dec.2022
CMPжҳҜд»Җйәјж„ҸжҖқпјҹиЈҪзЁӢж·ұе…Ҙд»Ӣзҙ№пјҢжё…жҘҡзһӯи§ЈжҠҖиЎ“иҲҮеҺҹзҗҶпјҒ
CMPжҳҜд»Җйәјж„ҸжҖқпјҹиЈҪзЁӢдёӯеҸҜжҮүз”ЁеңЁе“Әдәӣз’°зҜҖпјҹ
и®“дҪ еҝ«йҖҹдәҶи§ЈCMPиЈҪзЁӢзҡ„зӣёй—ңе…§е®№иҲҮжҮүз”ЁпјҒ -
02Nov.2022
иҶңеҺҡиЁҲзЁ®йЎһжңүе“Әдәӣпјҹжё…жҘҡдәҶи§ЈжҠҖиЎ“еҺҹзҗҶпјҢеҜҰйҡӣжҮүз”ЁзҜ„еңҚдёҖжҠҠжҠ“пјҒ
еёӮйқўдёҠиҶңеҺҡиЁҲзҷҫзҷҫж¬ҫи©ІжҖҺйәјйҒёж“Ү?е“ӘзЁ®йҮҸжё¬ж–№жҜ”ијғйҒ©еҗҲжҲ‘зҡ„жЁЈе“Ғ?
иҖғйҮҸдёҚеҗҢиҶңеұӨжқҗиіӘзЁ®йЎһгҖҒиЁӯзҪ®е ҙжүҖгҖҒй җз®—зӯүзӯүжңүдёҚеҗҢйҒёж“ҮгҖӮ -
10Jan.2022
гҖҗе…үеӯёиҶңеҺҡйҮҸжё¬гҖ‘еӨҡеұӨзөҗж§ӢзҹҪжҷ¶ең“жёӣи–„з ”зЈЁиҶңеҺҡйҮҸжё¬
當жҷ¶ең“йҖІиЎҢз ”зЈЁжҲ–иқ•еҲ»жёӣи–„еҺҡеәҰжҷӮпјҢйҖІиЎҢеҚіжҷӮеҺҡеәҰзӣЈжҺ§пјӣеҸҜж–јз·ҡдёҠзўәиӘҚз ”зЈЁеҺҡеәҰпјҢдёҚй ҲеҒңж©ҹзўәиӘҚпјҢжҸҗй«ҳиЈҪжҲҗж•ҲзҺҮгҖӮ